概要
故障の把握 / 確認から始まり、電気的な測定、
故障箇所の絞込みを経て、故障箇所の物理解析を行い
原因を明らかにして、工程にフィードバックする
受託分析サービスです。
パワーデバイスの故障解析
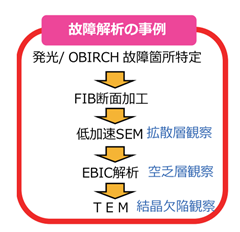
Si半導体だけではなく、SiC,GaNといった化合物半導体の解析
にも 対応しています。 故障箇所の特定後は、弊社独自の位置
出し技術 により、極めて高い精度で故障箇所の断面観察が可能
です。
故障箇所の特定
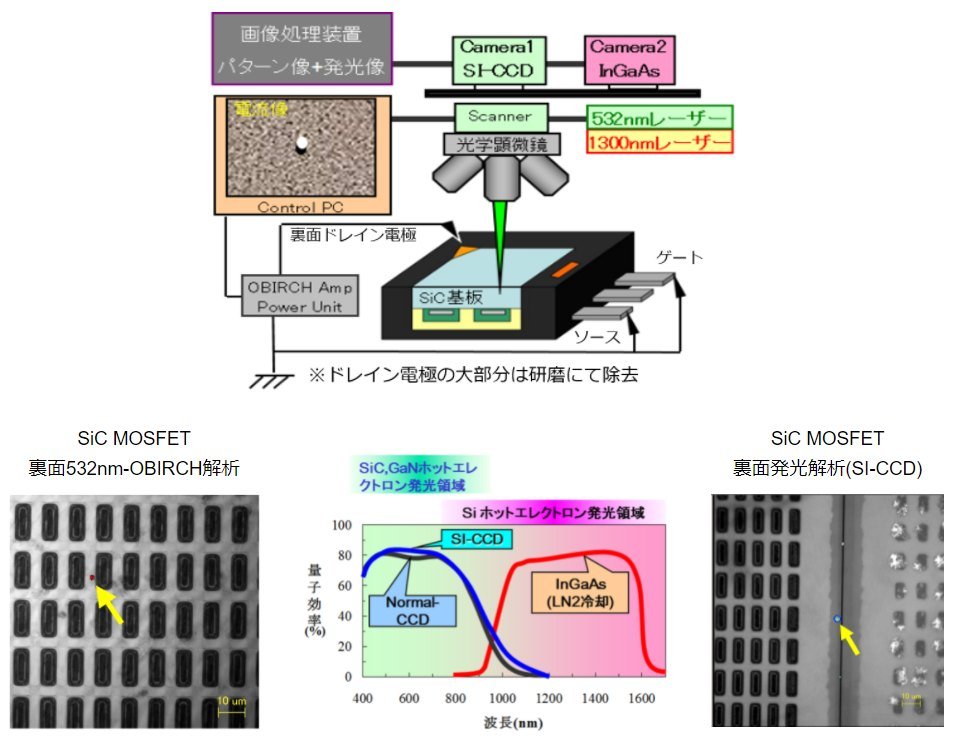
【発光解析/OBIRCH装置】
(1)IR-OBIRCH解析法
特 徴
・赤外レーザ照射に伴う抵抗の温度変化によって生じる電流変化を観察(レーザー波長:1,300nm)
・裏面観察可能、最大視野:13×13mm 応用例 パワーデバイスや受発光デバイス、ICチップ内部のショート箇所/リーク箇所やゲート酸化膜破壊箇所の特定
(2)可視光OBIRCH解析法
特 徴
・可視光レーザー照射に伴う抵抗の温度特性異常によって生じる電流変化を観察(レーザー波長:532nm)
・裏面観察可能(Siデバイスは不可)、最大視野:6.5×6.5mm
応用例 SiC、GaNパワーデバイスやTFTデバイスのショート箇所/リーク箇所や高抵抗箇所の特定
故障箇所への高精度位置特定

【集束イオンビーム装置FIB】
特 徴
・Gaイオンビームを利用したエッチング
・WおよびPtのデポジション 応用例 ・断面作成および観察
・TEM観察資料作製
拡散層観察
【低加速FE-SEM】
特 徴
・二次電子による表面形状観察
・光学顕微鏡に比べ高倍率(数10倍~30万倍程度)<br>で焦点深度が深い
応用例
・各種表面形状観察、微細形状の観察、
・ICチップ内部や部品実装部分の断面作製後の観察
空乏層観察
【EBIC解析装置】

特 徴
・EBIC電流の2次元マッピングによる空乏層の観察
応用例
・半導体部品の空乏層の観察
・SEM観察、TEM観察とセットで実施することで、
・同一サンプルにて拡散層と空乏層、結晶欠陥まで解析することが可能
結晶構造観察、元素分析
【透過型電子顕微鏡TEM】

特 徴
・透過電子による形状観察
・最大分解能:0.10nm(格子像)
0.24nm(粒子像)
応用例
・ICチップのビアやゲート酸化膜、LCDパネルのTFTなどの微小構造の
ナノレベル観察
故障箇所→拡散層評価を含めた物理解析・化学分析までトータルでサポート致します!
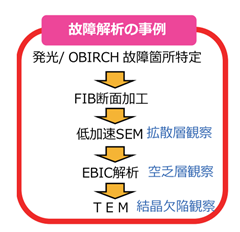
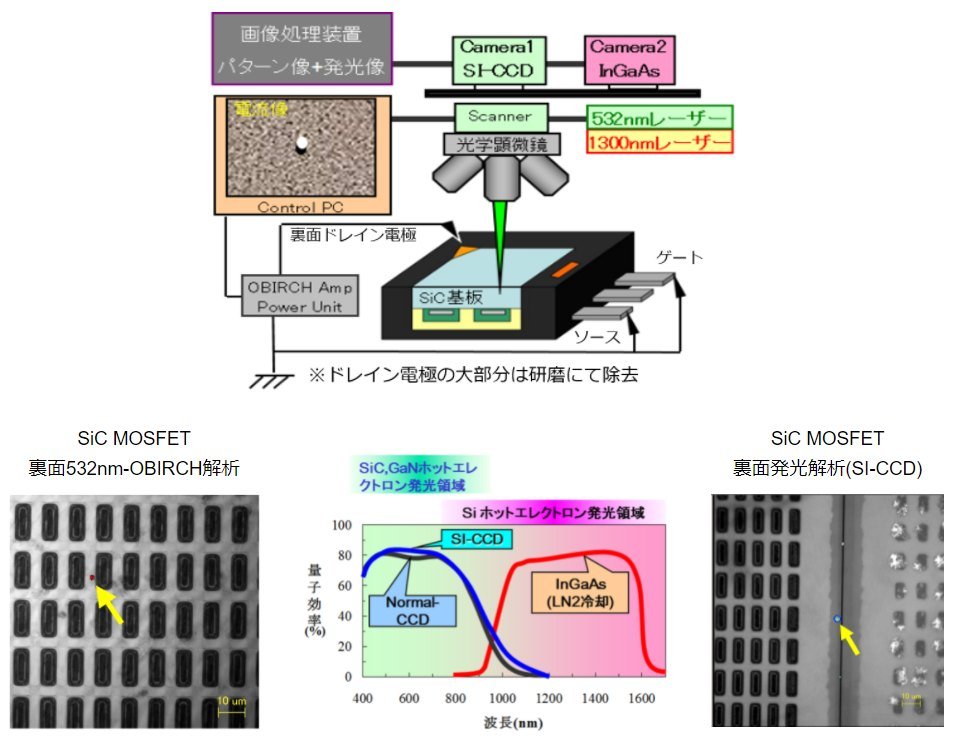
 【集束イオンビーム装置FIB】
【集束イオンビーム装置FIB】

